3 功率模块
3.1 功率模块的构造
在一个功率模块里,数个功率半导体芯片(MOSFET或IGBT芯片以及二极管芯片)被集成到一块共同的底板上,且模块的功率器件与其安装表面(散热板)相互绝缘。
这些芯片的底面被焊接于(或被粘贴于)一块绝缘基片的金属化表面上。该绝缘基片的作用是在保证良好导热性能的同时还提供了相对于模块底板的电气绝缘。芯片的上表面被金属化,它的电气连接可以采用细的铝制键接线用键接的方式来实现。
此外,采用混合电路或单芯片的方式,无源元件如栅极电阻、电流传感器或温度传感器(例如,具有正温度系数的电阻)也可以被集成到模块中。
下面列出了当前应用于功率模块的绝缘材料与基片。
3.1.1 绝缘材料
陶瓷:氧化铝(Al2O3)、氮化铝(AlN)、氧化铍(BeO)、四氮化三硅(Si3N4)。
有机材料:环氧树脂、聚酰亚胺。
3.1.2 基片
金属片:直接铜熔结DCB(Direct CopperBonding)、主动金属钎焊AMB(Active Metal Brazing)、绝缘金属基片IMS(Insulated Metal Substrate),多层绝缘金属基片(Multilayer-IMS)。
厚膜层:厚膜铜TFC(Thick Film Copper)。
3.1.2.1 DCB(直接铜熔结)
图24显示一个功率模块的结构。它包含了IGBT和续流二极管,采用了当今最为流行的技术,即以三氧化二铝或氮化铝DCB陶瓷作为绝缘基片。这类绝缘基片具有绝缘电压高和导热性能优良的特点。

图24 IGBT模块的结构(采用SEMITRANS2封装形式的SKM100GB123D)
制造DCB基片的绝缘材料一般厚度为0.38~0.63mm。在1000℃以上的高温作用下,绝缘基片的上下表面分别与约300μm厚的铜层共熔在一起。然后,对上表面的铜层进行蚀刻以得到模块所需的电路连接,并将芯片焊接于其上,而芯片上表面之间的连接则采用键接。DCB基片的底部被固定在模块底板(约3mm厚)上,方式多为焊接,见图24。
还有其他的封装形式(例如,SEMITOP、SKiiPPACK、MiniSKiiP)。在这类模块中,利用特殊设计的外壳结构,DCB陶瓷基片被直接压到散热器表面。由于省去了底板,而少了一个焊接过程。
如果将DCB技术与其他封装形式相比较,则它的优点主要在于:铜层较厚,因而可以提供较大的电流承载力;陶瓷材料具有良好的传热能力,因而便于冷却;铜材料在陶瓷上具有很强的附着力,因而提高了可靠性。
3.1.2.2 AMB(主动金属钎焊)
AMB方法(将金属膜硬焊接至基片的方法)是DCB技术的进一步发展。与基于氧化铝陶瓷材料的基片相比,采用AlN陶瓷材料的AMB基片有着更小的热阻、更低的热膨胀系数和更稳定的部分放电能力。
图25清楚地显示了DCB和AMB的区别。
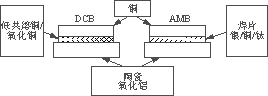
图25 直接铜熔结DCB与主动金属钎焊AMB
3.1.2.3 IMS(绝缘金属基片)
IMS主要被应用于低成本与小功率领域,它的特点是绝缘材料被直接置于底板之上。绝缘体多为聚合物,如环氧树脂、聚酰亚胺等,被放在一块铝底板上。在绝缘体上表面则粘贴了一层薄膜状的铜层,通过对铜层的蚀刻便可以获得所需的电路结构(类似于印刷线路板的制造),如图26所示。
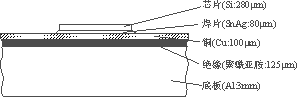
图26 IMS功率模块的基本结构
与DCB技术相比,IMS技术的优点在于其成本低、可以实现精细的结构(驱动和保护装置的集成变为可能)、基片的机械强度高、以及基片面积相对较大。
然而,因其绝缘层非常薄,导致了相对于安装面积较大的耦合电容,另外,其上表面极薄的铜层不利于芯片的热扩散。针对这一点的改善措施可以是在芯片下面附加金属化的热扩散层或在绝缘层中掺铝。
3.1.2.4 TFC(厚膜铜)厚膜基片
与DCB相同,厚膜片的基本材料也是绝缘陶瓷。但它可以用硅胶直接被粘贴于或焊接于底板以及散热片之上,如图27所示。

图27 TFC功率模块的基本结构
陶瓷上表面的印制电路由铜组成,并通过筛印方法而得到。功率半导体芯片或其他元件则被焊接于或粘贴于印制电路上。
TFC技术还可以与标准的厚膜技术相结合使用。
由于采用厚膜技术中常见的材料可以实现几何尺寸很小的电阻,以及相互绝缘的印制电路可以被分层与重叠,所以,在一块小面积上可以集成相当多的系统元器件。但由于印制电路的连线非常细(例如15μm),此类构造的电流承载能力局限在10A以内。
3.2 功率模块的性能
评价功率模块各参数的重要性总是和其所应用的领域密切相关,例如,在机车牵引中可靠性最为重要,而在家用消费品中低成本则是决定性的因素。
我们将根据下列的判据来分析功率模块的可应用性,包括“优化的”模块复杂度、散热能力、绝缘电压及漏电稳定性、内部连接承受温度或负载循环的能力、低电感的内部结构、静态和动态的结构对称性、低电磁干扰的内部结构、模块发生损坏时确定且不危险的行为、简单的安装和连接技术、以及无污染的制造过程可回收性。
3.2.1 复杂度
最佳的复杂度不能用一个普遍适用的概念来定义。一方面,复杂的模块可以降低系统的成本,还可以使在组合各个部件时可能产生的问题(寄生电感、干扰、接线错误)减到最少。
另一方面,随着模块复杂度的增加,其通用性则会降低(产量降低),且单只模块的测试数量和成本也随之增加。随着模块内部元器件和接线数量的增加,其损坏的概率也变大,发生故障时所需的修理也更复杂。对模块的驱动、测量和保护装置而言,也要求具有更高的散热能力和抗电磁干扰的能力。
迄今为止,在驱动电路的集成方面还未形成为各方所接受的“世界标准”。由于驱动功能经常地被集成到模块中,功率模块的通用性越来越受到限制,模块正在逐步成为子系统。
一方面,“智能”模块瞄准了那些真正的大批量市场(消费品、汽车);另一方面,也正在涉及这样的市场,在其中众多相似的应用可建立在具有相同基本元素的新式模块上。尽管有时会出现不可避免的重复,但制造者所获得的节约效应还是可以使应用者降低其系统的总成本。
图28所示为在市场上广为应用的、含有IGBT和二极管的功率模块电路,图28中所列举的电路得到了广泛的接受,并被大量地应用于功率电子技术和拖动技术。这些电路形式也同样适用于功率MOSFET模块,其应用的重点目前是电源技术。
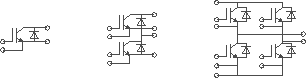
(a)GA (b)GB (c)GH

(d)GAH (e)GD

(f)GAL (g) GAR (h)GDL

(i)GT

(j)GAX (k)GAY (l)GBD
(a)单开关,由IGBT和反向二极管混合组成(在MOSFET情形下,此处多仅为一个寄生的反向二极管)。若外电路为桥式电路,则反向二极管工作在续流模式下。
(b)两单元模块(半桥),由两个IGBT和两个混合的反向二极管组成(续流二极管)
(c)H桥(单相桥),由两个含IGBT和续流二极管的桥臂组成。
(d)不对称H桥,在一条对角线上有两个IGBT以及混合反向二极管,而在另一条对角线上有两个续流二极管。
(e)三相桥(六单元或逆变桥),由三个含IGBT和续流二极管的桥臂组成。
(f)斩波模块,由IGBT和反向二极管加集电极端的续流二极管组成。
(g)斩波模块,由IGBT和反向二极管加发射极端的续流二极管组成。
(h)三相桥GD加斩波GAL(制动斩波电路)。
(i)三单元模块,由三组开关组成。
(j)单开关加集电极端的串联二极管(反向阻断开关)。
(k)单开关加发射极端的串联二极管(反向阻断开关)。
(l)两单元模块,带串联二极管(反向阻断开关)。
图28 含IGBT和续流二极管的功率模块的常见电路单元
3.2.2 散热能力
为了尽可能地充分利用芯片的理论电流承载能力,芯片所产生的功率损耗需要通过连接部分和绝缘层直接并安全地被引导至散热表面。
图29从原理上显示了模块中哪些内部参数会影响其散热能力(内部热阻R、内部热抗Z),这些参数与散热能力以及环境条件共同决定了模块所允许的最高损耗(电流、开关频率、电压等)。
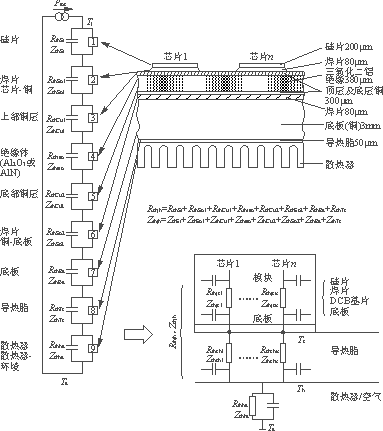
图29 含DCB的功率模块的基本结构及其传热图
图29中所示的RC元件并没有真实地反映热传导的物理过程,它们只是被用来形象地表明从芯片到散热器之间功率和温度是由上而下流动的。但由于热阻Rth是一个静态的参数,所以,它可以被用来反映相应的结构单元。
然而,电容替代了真实的物理单元,它可以由实际体积元器件的热容量(参数为体积和单位热容)通过变换而得到,其条件是存在一个共同的热参考点。
芯片在导通与截止状态下以及在开关过程中会产生损耗Ptot。其散热能力可以用降落在芯片与散热器之间的温度差来描述:
ΔTjh=Tj-Th(14)
式中:Tj是芯片温度,Th是散热器温度。
这个温差与损耗之商即为热阻Rthjh(静态),在过渡过程中我们还使用热抗Zthjh。
图29显示了模块内部各单元对Rthjh和Zthjh的影响,它包括:
1)芯片(表面、厚度、几何形状和放置);
2)DCB基片的构造(材料、厚度、基片上表面的结构);
3)芯片与基片之间连接的材料和质量(焊接、粘贴);
4)底板的存在与否(材料、形状);
5)基片底面与底板之间的焊接(材料、质量);
6)模块的安装(表面状况、与散热片表面的热连接、导热脂或导热膜的厚度与质量);
7)在复杂的功率模块中还有芯片之间的发热交互影响(热耦合)。
对于具有底板的模块来说,其外部热阻以及热抗的符号为Rthch以及Zthch(从底板至散热片),而其内部热阻以及热抗(从芯片至底板)的符号为Rthjc和Zthjc。
Rthjh=Rthjc+Rthch(15)
Zthjh=Zthjc+Zthch(16)
图30显示了上述影响因素分别在模块Rthjc中所占的比重。图中的模块采用了目前最为广泛应用的Al2O3DCB基片和铜底板。
由图30可见,热阻的最大一部分是模块的内部绝缘(如果采用薄膜或其他外部绝缘方式作为替代的话,则热阻还会再增加20%~50%)。标准的Al2O3(热导λ=24W/m·K)DCB基片的纯度为96%。但若采用高纯度(99%)的Al2O3或AIN(λ=150W/m·K)则可使热阻得到进一步的改善。所以,特别是在高绝缘电压的模块(绝缘陶瓷因而比较厚)中,AIN目前已受到了广泛的欢迎。

图30 一个1200V功率模块内部热阻的比例分布(芯片面积9mm×9mm)
尽管底板由高导热材料(Cu:λ=393W/m·K)所组成,但由于其厚度(2.5~4.5mm)的关系使它的热阻仍然占据了模块热阻的相当部分。采用较薄的底板只能够有限地降低这一比重,原因在于厚的底板具有扩张温度场的效应,从而使芯片下层的热穿透面积增加。在不含底板的模块中,由于底板以及底面焊接的热阻不再存在,因而能够补偿这种热扩张效应的降低。
还有,如果采用合适的封装技术(将大面积的DCB压接在散热器上),则芯片与基片之间的连接可以更紧密。作为对照,含有底板的模块在焊接时不可避免地会产生变形,且因为底板只能够在四周通过螺钉来固定到散热器上,如图31所示,模块与散热器的表面并不完全接触。

(a)带有底板的模块在安装前(底板具有预弯曲)

(b)带有底板的模块在安装后(底板严重变形)
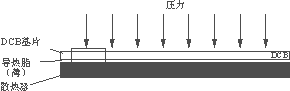
(c)不带底板的DCB模块
(例如,SEMITOP、SKiiP、MiniSKiiP)
图31 功率模块与散热器接触界面可能发生的问题
同样不可以忽略的是芯片和基片以及基片和底板(如果存在的话)之间的接触热阻,该界面多通过焊接而形成(例如,λ=75W/m·K)。在不采用底板的情况下,这一部分的热阻可以减少约50%。
基片的金属表面在热阻中所占的比例主要由上表面铜层的结构所决定,该结构被用来放置芯片并实现模块内部的电气连接。由于基片底部铜层在垂直方向上的散热基本不受任何阻碍,所以,热量的传导以及扩张效应实际受到芯片下面铜层几何形状的限制。
硅芯片在总热阻中所占的比例随着芯片的厚度的增加而增加,而芯片的厚度又是由其正向截止电压以及制造技术所决定的。
还有,芯片的面积决定了芯片与底板或散热器之间的传热面积。
3.2.3 绝缘电压与漏电稳定性
随着IGBT模块进入越来越高的电压领域,有关对高绝缘电压和高漏电稳定性的要求也相应增加。
绝缘和漏电稳定性取决于芯片底部绝缘的厚度、材料、均匀度,以及外壳的材料。在某些情况下也取决于芯片的布置。
目前的晶体管模块具有2.5~9kV(有效值)的绝缘测试电压。在生产过程中,每一个模块都需要经过测试。
图32显示了各种标准厚度的绝缘基片所能够达到的最大绝缘电压。
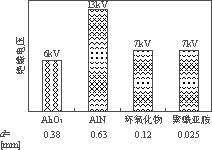
图32 不同绝缘基片的绝缘电压(DCB、IMS、TFC)
3.2.4 负载循环能力
当开关频率小于3kHz时,特别是间歇运行时,例如,拖动、电梯或脉冲负载,负载的变化会导致模块内部连接的温度变化。模块的内部连接是指
1)键接;
2)芯片底部的焊接;
3)陶瓷基片和金属底板之间的焊接;
4)金属与陶瓷基片间的熔接(金属铜生长于Al2O3或AlN之上)。
在加工和运行时,这些材料在长度方向上的膨胀系数的不同,会因受热而产生变形程度的不一致,最终导致材料的疲劳和磨损。芯片的寿命(可能的开关次数)随着芯片温度变化幅度的增加而降低。
由功率模块的结构可知,陶瓷基片和铜底板之间的焊接最为重要,原因是它(当相邻两种物质的膨胀系数之差大致相同时)明显地具有最大的面积。因此,有必要采用高质量的焊料和焊接方法,以避免陶瓷基片在温度大幅度变化时的变形和损坏。
此外,采用多块陶瓷基片,用以减小单块基片的面积也是常用的办法,这个方法可以尽可能地减小温度膨胀的绝对数值。
3.2.5 模块内部的低电感设计
以一个半桥模块为例,图33显示了模块内部最主要的寄生电感。由于芯片之间的连接以及芯片对模块端子的连接(键接线和内部连线)必不可少,所以产生了这些电感。
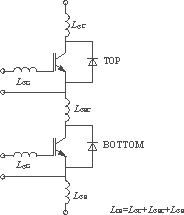
图33 两单元IGBT模块的寄生电感
LσG——栅极寄生电感;
LσC——上开关集电极寄生电感;
LσEC——上开关发射极与下开关集电极之间的寄生电感;
LσE——下开关发射极寄生电感;
LCE——上开关集电极与下开关发射极之间的总寄生电感;
由于这些电感会在关断时感应过电压,在开通时延缓电流上升速度di/dt,以及在控制和功率电路之间引起电感式耦合,如何减小它们会直接影响到功率模块的使用。
另外,如果模块内部的芯片是并联的,则寄生电感会引起芯片的动态不均衡以及芯片之间的振荡。
在以后的章节还将进一步讨论此现象。
3.2.6 内部结构与电磁干扰
由于MOSFET和IGBT模块的电流和电压上升时间极短,多位于ns级范围之内,所以,它们会产生频率远在MHz之外的电磁干扰。干扰电压的幅度主要受模块内部的寄生元件,还有干扰在模块内以及接口处的传播途径的影响。
通过选择合适的绝缘材料、减小耦合面积或者应用导电屏蔽可以降低非对称干扰。
此外,选择合适的内部连线结构,避免由于外部电磁场或者变压器式耦合对控制线的干扰而引起的误动作。
电磁干扰在另一方面的体现是对地电流,即iE=CEdvCE/dt。该电流源于绝缘基片的电容CE,由IGBT在开关时所产生的dvCE/dt所引起,并通过接地的散热器流入保护地端子。
相对来说,绝缘底板的电容越低,则允许的开关速度便越高。
图34列举了常用的具有标准厚度的基片材料的电容值。基于材料不同的电介质常数以及不同的标准厚度,电容值CE也相应不同,并决定了在最大允许对地电流条件下所允许的最高开关速度。标准厚度是由导热能力所决定的,例如,AlN基片的值最大,为630μm,而IMS的值最小,为120μm(采用环氧树脂绝缘时)或25μm(采用聚酰亚胺绝缘时)。
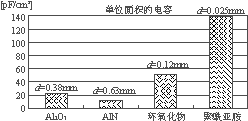
图34 不同绝缘基片单位面积的电容值
3.2.7 模块在失效时可定义的安全行为
在模块失效的情况下(比如说由驱动错误引起),以一个电压型电路为例,储存在直流母线电路中的全部能量将注入到模块中。在键接线熔断后,这一能量的绝大部分会形成电弧,进而可能导致模块爆炸。
在传统的模块中,这一现象可能引起电路中断,主电路短路、甚至绝缘被烧毁。电弧和模块的残骸会高速射向模块的周围。
通过良好的模块外壳设计,可以使此类危险降低至最低程度,并将爆发的物质引导至一个固定的方向。
3.2.8 无污染回收
通常,目前的功率模块已经避免使用有毒材料(例如BeO),而且材料的种类也在尽可能地减少。
外壳和其他材料应该具有阻燃性,并且在燃烧时不能产生毒气(UL认证)。
模块在回收时应该能够被简单地分离为金属和非金属部分。因此,新型的模块仅含有弹性的注入材料(软注入)。
